MEMS
何謂MEMS?
MEMS是Micro Electro Mechanical Systems(微機電系統)的縮寫,具有微小的立體結構(三維結構),是處理各種輸入、輸出信號的系統的統稱。
是利用微細加工技術,將機械零件、電子電路、感測器、致動器集約在一塊電路板上的高附加值元件。
MEMS工藝
MEMS工藝以成膜工序、光刻工序、蝕刻工序等常規半導體工藝流程為基礎。
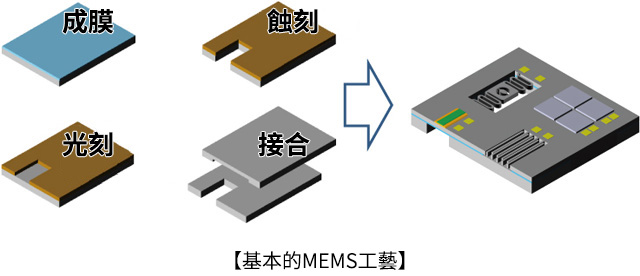
下面介紹MEMS工藝的部分關鍵技術。
晶圓
- SOI晶圓
- SOI是Silicon On Insulator的縮寫,是指在氧化膜上形成了單晶矽層的矽晶圓。已廣泛應用於功率元件和MEMS等,在MEMS中可以使用氧化膜層作為矽蝕刻的阻擋層,因此能夠形成複雜的三維立體結構。
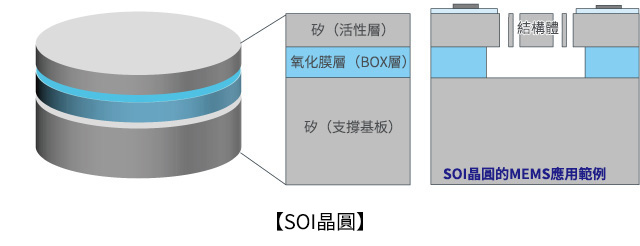
TAIKO磨削 “TAIKO”是DISCO株式會社的商標
TAIKO磨削是DISCO公司開發的技術,在磨削晶圓時保留邊緣區域,只對其內側進行磨削。
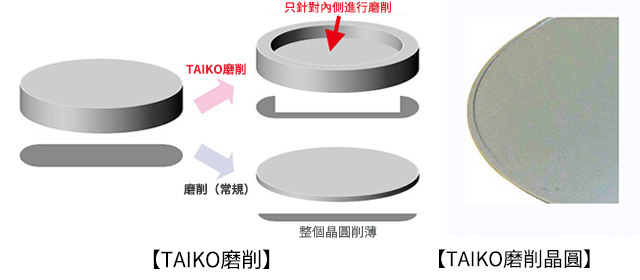
TAIKO磨削與通常的磨削相比,具有“晶圓曲翹減少”、“晶圓強度更高”、“處理容易”、“與其他製程的整合性更高”等優點。
- 晶圓粘合/熱剝離片工藝
- 透過使用支撐晶圓和熱剝離片,可以輕鬆對薄化晶圓進行處理等。

- 晶圓接合
- 晶圓接合大致分為“直接接合”、“透過中間層接合”2類。
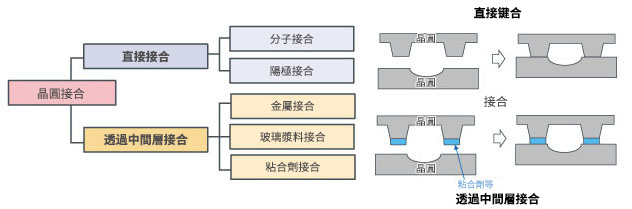
直接接合不使用粘合劑等,是利用熱處理產生的分子間力量,使晶圓相互粘合的接合,用於製作SOI晶圓等。
透過中間層接合是借助粘合劑等使晶圓互相粘合的接合方法。
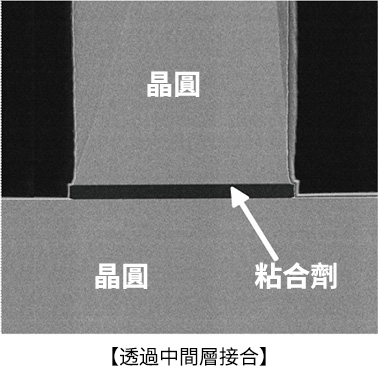
蝕刻
- 等向性蝕刻與非等向蝕刻
- 透過在低真空中放電使等離子體產生離子等粒子,利用該粒子進行蝕刻的技術稱為反應離子蝕刻。
等離子體中混合存在著攜帶電荷的離子和中性的自由基,具有利用自由基的等向性蝕刻、利用離子的非等向蝕刻兩種蝕刻作用。
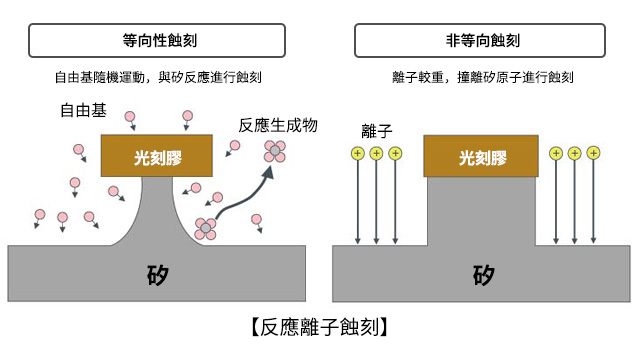
- 矽深度蝕刻
- 匯集非等向蝕刻和等向性蝕刻的優點於一身的博世製程技術,已經成為了矽深度蝕刻的主流技術。
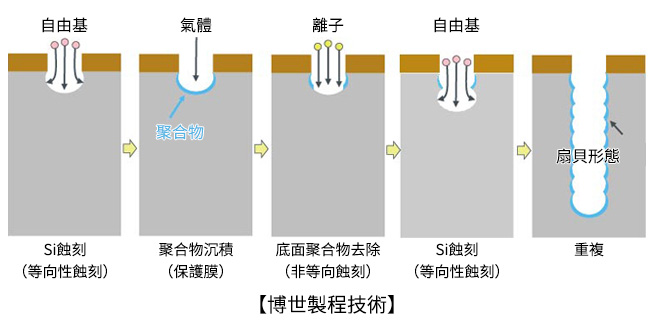
透過重複進行Si蝕刻⇒聚合物沉積⇒底面聚合物去除,可以進行縱向的深度蝕刻。
側壁的凹凸因形似扇貝,稱為“扇貝形態”。
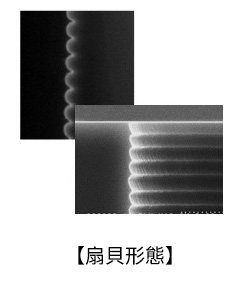
成膜
- ALD(原子層沉積)
- ALD是Atomic Layer Deposition(原子層沉積)的縮寫,是透過重複進行材料供應(前體)和排氣,利用與基板之間的表面反應,分步逐層沉積原子的成膜方式。
透過採用這種方式,只要有成膜材料可以透過的縫隙,就能以納米等級的膜厚控制,在小孔側壁和深孔底部等部位成膜,在深度蝕刻時的聚合物沉積等MEMS加工中形成均勻的成膜。
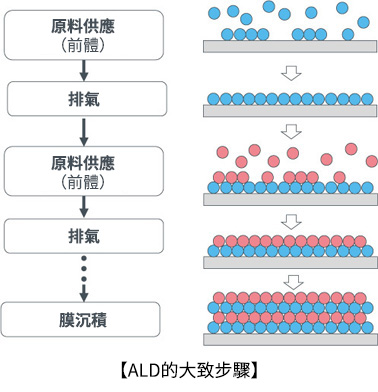
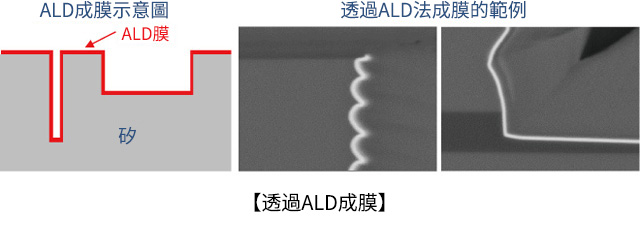
羅姆的薄膜壓電MEMS代工運用自身擁有的先進薄膜壓電技術和MEMS加工技術,以及得到了量產業績印證的先進生產技術,為實現小型、節能、高性能產品,提供從試製、開發到量產的全程支援。
下頁是關於MEMS相關用語的簡要總結。



